Solar Energy Research Institute

Institut Penyelidikan Tenaga Suria | Solar Energy Research Institute
Atomic Force Microscopy
(Brand: Nanosurf)
(Model : Nanosurf Easyscan 2)
|
Items |
Details |
Description |
The Nanosurf easyScan 2 AFM is an atomic force microscope system that can make nanometer scale resolution measurements of topography and several other properties of a sample. |
Operator |
Encik Muhammad Samsuri Samsudin(03-89217158/ msamsuri@ukm.edu.my) |
Charge |
RM60/ sample (UKM’s staff and students) RM100/sample (External students and industry) |
High Precision 4 Point Probe

Items | Details |
Description | Four-point probing is a technique used to measure the electrical resistivity of thin films and silicon substrates. It involves applying a potential difference across four contacts made to the sample and measuring the resulting current flow. |
Type of Service | Resistance Measurement |
Operator | En. Amirul Iman Bin Zainudin |
For further inquiries, please contact our officer at amiruliman@ukm.edu.my | |
Scanning Kelvin Probe

Items | Details |
Description | Our large range of Scanning Kelvin Probes give the user full access to 2D and 3D work function plots of samples ranging in size from 50 mm to 350mm. With work function resolution of 1-3 meV, and the spatial resolution of the probe tip diameter, the Scanning Kelvin Probe gives reliable, repeatable measurements for work function (Φ) and contact potential difference (CPD) measurements. Effects of corrosion can be measured across a surface with high precision e.g. coating uniformity and performance. A Faraday enclosure shields all of our scanning systems from unwanted ambient light, fast changing environmental conditions, electromagnetic interference and provides the perfect platform for our Ambient-pressure Photoemission Spectroscopy (APS) and Surface Photovoltage add-on modules. |
Type of Service | FEATURES • Work function measurement • Work function resolution of 1-3 meV • Scanning area from 50mm2 to 350mm2 • Scanning resolution equal to tip diameter • Automatic height regulation • Tip diameter 2.00mm or 0.05mm (SKP5050) |
Operator | En. Amirul Iman Bin Zainudin |
For further inquiries, please contact our officer at amiruliman@ukm.edu.my | |
Light -Induced-Current-Voltage
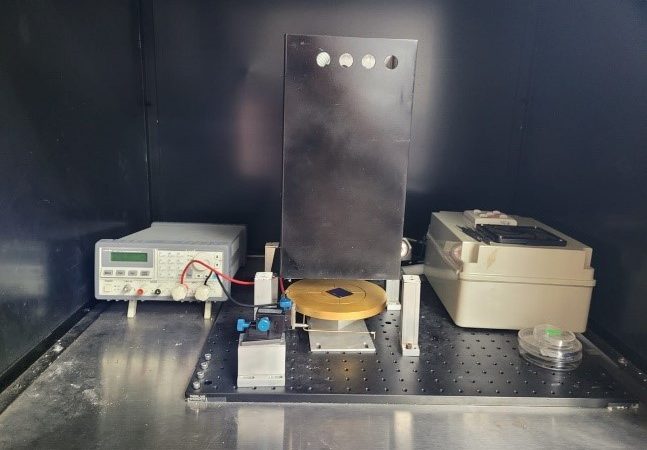
Items | Details |
Description | Solar simulators are fundamental devices for characterization of photonic properties. The solar simulator has special air mass filters and lamps to simulate the sun׳s solar spectrum. For this type of measurements, the solar simulator is integrated into an IV measuring station. For setting the correct irradiance value we offer calibrated reference cells.
|
Type of Sample | Monocrystal silicon and polycrystalline silicon |
Operator | En. Amirul Iman Bin Zainudin |
For further inquiries, please contact our officer at amiruliman@ukm.edu.my | |
Elipsometer

Items | Details |
Description | The spectroscopic ellipsometers is engineered to meet the diverse demands of thin film characterization. An advanced optical design, wide spectral range, and fast data acquisition combine in an extremely powerful and versatile tool. The instrument delivers both speed, accuracy and patented RCE technology combines Rotating Compensator Ellipsometry with high-speed CCD detection to collect the entire spectrum (hundreds of wavelengths) in a fraction of a second with a wide array of configurations. |
Type of Service | · Characterize both thickness and refractive index for single- and multi-layer coatings; anti-reflection, high-reflection, or decorative coatings. Calculate the color coordinates for your coating stack under different lighting conditions. · Great progress has occurred in the area of organic layers and stacks used for display (OLED) or photovoltaic applications. There are many different materials being studied, from small molecules such as Alq3 to conjugated polymers such as P3HT. Often multiple materials are blended together – which requires the wide spectral range of the M-2000 – to probe different wavelengths where the organics are optically different. Long-chain molecules may also have significant anisotropy, where orientational stacking of the polymer chains produces different optical constants in different directions. · Traditional ellipsometry applications are still going strong. Characterize any semiconductor material: resists, photomasks, SiON, ONO stacks, low-k dielectrics, high-k gates, SOI, SiGe, II-VI and III-V ternary and quaternary compounds. · Film thickness and optical properties are critical to performance of solar devices. Ellipsometry is used for development and monitoring of all PV materials: a-Si, μc-Si, poly-Si, AR Coatings (SiNx, AlNx…), TCO Films (ITO, ZnOx, doped SnO2, AZO), CdS, CdTe, CIGS, organic PV materials, and dye sensitized films. |
Operator | En. Amirul Iman Bin Zainudin |
For further inquiries, please contact our officer at amiruliman@ukm.edu.my | |
Optical Profilometer

Items | Details |
Description | The optical profiler provides 3D metrology and imaging capability, combined with an integrated isolation table and configuration flexibility to handle larger samples. The 3D optical metrology system simultaneously collects high-resolution 3D data and a True Color infinite focus image. The non-contact profiler supports both R&D and production environments with Multi-Mode optics, easy-to-use software, and a low cost of ownership |
Application | · Measuring 3D, non-contact step heights from nanometers to millimetres · Capable of measuring film thickness of transparent film(s) using ZDot or ZFT measurement techniques. · Measures 3D texture, quantifying the sample’s roughness and waviness. · Measure the 2D and 3D shape or bow of a surface. · Measuring stress induced during the manufacture of devices with multiple layers, such as semiconductor or compound semiconductor devices. · Automated Optical Inspection (AOI) to rapidly inspect the sample, differentiate different defect types, and map defect density across the sample. · Defect review uses an inspection tool KLARF file to drive the stage to the defect locations · Supports metrology and inspection of patterned sapphire substrates · Supports Wafer-Level Chip Scale Packaging (WLCSP) and Fan-Out Wafer Level Packaging (FOWLP) metrology requirements · Measure topography changes induced by laser surface processing for semiconductors, LED, microfluidic devices, PCBs, and more. · Measure microfluidic devices fabricated in materials, such as silicon, glass, and polymers. The system quantifies the height, width, edge profile, and texture of channels, wells, and control structures
|
Operator | En. Amirul Iman Bin Zainudin |
For further inquiries, please contact our officer at amiruliman@ukm.edu.my | |
RAMAN Spectroscopy Services and Analysis
Equipment: Anton PAAR Cora 5001 RAMAN Spectrometers

Items | Details |
Description | 1. Easy and safe – user guidance and laser Class 1. The laser can only be activated if the measuring chamber is closed and therefore poses no threat to people working in close vicinity to the device.2. No sample preparation – accessories to boost efficiency. Regardless of whether the sample is a solid, liquid, or powder, Cora 5001 has the appropriate sample holder for it. You can use vials with various diameters and shapes (round, square, rectangular) or directly analyze solid samples (pills, sample carriers, etc.).3. Autofocus – the strongest signal for reproducible results. It automatically finds the spot with the best Raman signal within seconds. |
Type of Service | 1. Single measurement 2. Time-dependence 3. Time-dependence data analysis 4. Consultation services |
Type of Sample | Tailored accessories for liquid and solid samples, pills, foils, microscope slides, and petri dishes |
Operator | Encik Amirul Iman Bin Zainudin(03-89217159/ amiruliman@ukm.edu.my) |
No | Instrument | Charge (RM) | |
|
| UKM’s Staff & Student | External Student & Industry |
1 | Single measurement (Ex-situ) | RM100/ sample | RM200/ sample |
2 | Time-dependence (In-situ) | RM300/ sample | RM600/ sample |
3 | Time-dependence data analysis | RM400/ sample | |
4 | Consultation fees | RM400/ sample | |
Laminator

|
Items |
Details |
|
Description |
The laminator is used to encapsulate the photovoltaic cells within a protective sandwich of materials. The main component in silicon panel assembly are frame, glass, Ethyl Vinyl Acetate (EVA), solar cell and Tedlar film (TPT back sheet). The temperature used for this process is 110 – 130 C. |
|
Type of Service |
To laminate the silicon solar cell at bigger size 1 meter x 1 meter. It can laminate to 200 W solar panel. Charge of service : depend on panel size. |
|
Operator |
En Muhammad Samsuri |
|
For further inquiries, please contact Person In Charge : Associate Prof. Dr. Suhaila Sepeai (suhailas@ukm.edu.my) |
|
Hotpress

Items | Details |
Description | The hot press apply heat and pressure to laminate materials Specification : Hot plate size: 15 cm x 20 cm, Max sample height : 7 cm, |
Type of | To laminate the solar cell at small size; 5 cm x 5 cm and 10 cm x 10 |
Operator | En Muhammad Samsuri Samsudin |
For Associate Prof. Dr. Suhaila Sepeai | |
Laser Cutter

Items | Details |
Description | The laser cutter is used as a precision tool to cut and pattern materials such as silicon wafers and aluminum sheets with thicknesses of less than 700µm. This process involves using focused 1064nm laser beams with carefully adjusted parameters. |
Type of Service | 1. To cut wafer to 10cm x 10cm and below. 2. Surface patterning. Charge: RM150/ sample |
Operator | En. Muhammad Samsuri |
For further inquiries, please contact Person In Charge : Associate Prof. Dr. Suhaila Sepeai (suhailas@ukm.edu.my) | |